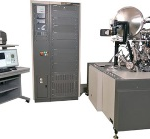 Nanotof
Nanotof
La espectrometría de masas iónicas secundarias en el tiempo de vuelo (TOF-SIMS) proporciona información elemental, química y molecular de las superficies de los materiales sólidos. La profundidad de análisis promedio para una medición TOF-SIMS es de aproximadamente 1 nm. La electrónica física Los instrumentos TOF-SIMS proporcionan una resolución espacial máxima de menos de 0.1 µm. La información de distribución espacial se obtiene escaneando un haz de iones micro enfocado a través de la superficie de la muestra. La información de distribución de profundidad se obtiene combinando mediciones TOF-SIMS con molienda iónica (sputtering) para caracterizar una estructura de película delgada. Además, el instrumento TOF-SIMS de física electrónica proporciona una capacidad de análisis 3D única que combina el seccionamiento de haz de iones enfocado in situ con imágenes de alta resolución en masa y alta resolución espacial (HR2) para proporcionar una caracterización química en 3D. La información que TOF-SIMS proporciona sobre las capas superficiales o las estructuras de película delgada es importante para muchas aplicaciones industriales y de investigación donde la composición de la película superficial o delgada juega un papel crítico en el rendimiento, incluidos: nanomateriales, energía fotovoltaica, modificación de la superficie del polímero, catálisis, corrosión, adhesión, semiconductores dispositivos y empaques, medios magnéticos, tecnología de visualización, recubrimientos de película delgada y materiales médicos utilizados para numerosas aplicaciones.
TOF-SIMS se logra excitando una superficie de muestras con un haz de iones finamente enfocado que hace que se emitan iones secundarios y grupos de iones desde la superficie de las muestras. Se utiliza un analizador de tiempo de vuelo para medir la masa exacta de los iones y grupos emitidos. A partir de la masa exacta y la intensidad del pico SIMS, se puede determinar la identidad de un elemento o fragmentos moleculares.
La electrónica física Los instrumentos TOF-SIMS funcionan de manera análoga a los instrumentos SEM / EDS que utilizan un haz de electrones finamente enfocado para crear imágenes SEM para ver muestras y espectros puntuales o imágenes para análisis de composición. A diferencia de SEM / EDS, que tiene una profundidad de análisis típica de 1-3 µm, TOF-SIMS es una técnica de análisis de superficie con una profundidad de análisis típica de menos de 2 nm y, por lo tanto, es más adecuada para el análisis de composición de capas ultrafinas y características de muestra a nanoescala. Además, TOF-SIMS se puede utilizar para caracterizar información molecular de materiales orgánicos y secciones de tejidos para investigación médica que no sería posible con SEM / EDS.
PHI nanoTOF IITime-of-Flight SIMS El espectrómetro de masas TRIFT patentado de PHI con Parallel Imaging MS / MS proporciona una sensibilidad superior, un fondo espectral bajo, una capacidad única para obtener imágenes de superficies altamente topográficas, alta precisión de masa y resolución de masa, e identificación inequívoca de picos de alta masa con capacidad de imagen de MS en tándem paralelo.